
是来自一种可以将物质以单原子膜形式一层一层的镀在基底表面的方法。原子层沉积与普通的化学沉积有相似之处。但在原子层沉积过程中,新一层原子膜的化学反应是直接与之前一层360百科相关联的,这画马接种方式使每次反应只沉积一层原子。
即罪原子层沉积(Atomic layer deposition)是一种可以将物远药吸质以单原子膜形式一层一层的镀在基底表面的方法。原子层沉积与普通的化学沉积有相似之处。
但在原子层沉积过程中,新一层原子膜的化学够斯轻会品反应是直接与之前一层相关联的,这种方式使每次反应只沉积一层原子。
单原子层沉积(atomic layer deposition,ALD),又称原子层沉积或原子层外延(atomic layer epitaxy) 来自,最初是由芬兰科学家提出并用于长渐帝速国多晶荧光材料ZnS:Mn以及非晶Al2O3绝缘膜的研制,这些材料是用于平板显示器。由于这一工艺涉及复杂的表面化学过程和低的沉积速度,直至上世纪80年代中后期该技术并没有取得个实质性的突破。
360百科 但是到了20世纪90年代中期,人们对这一技术的兴趣在不断加强,这主要是由于微电子和深亚微米芯片技术的发展要求器件和材料的尺寸不断降低,而器件中的高宽比不断增加,这样所使用材料的厚度降低至几个纳米数量级。
因此,原子层沉积技术的优势就体现出来,如单原子层逐次沉积,沉积层极均匀的厚度和优异的一致性等就体现出来,而沉积速度慢的问题就不重要了。以下主要讨论原子层沉积原理和化学,操的变原子层沉积与其他相关技术的比较,原子层沉积率黄告银滑统他突设备,原子层沉积的应用和双安举连棉检教他啊再原子层沉积技术的发展。
 原子等逐办联需角位杀混将互层沉积
原子等逐办联需角位杀混将互层沉积 原子层沉积是通过将气相前驱体氢怎期及道犯苦始风化另脉冲交替地通入反应器并在沉积基体上化学吸附并反应而形成沉积膜的一种方法(技术)。当前驱体达到沉积基体表面,它们会在其表面化学吸附并发生表面反应。在前驱体脉冲之间需要用惰性气体对原子层沉积反应器进行清洗。由此可知沉积反应前驱体物质能否在被沉积材料表面化学吸附是实现原子层沉积的关键。气相物质在基体材料的表面吸附特征可以看出,任何气相物质在材料表面都可以进行物理吸附,但是要在材料表面的化学吸附必须具有一定的活化能,因此章够度东演写胞贵落担能否实现原子层沉积,选择合适的企标诉深大够甚反应前驱体物质是很重万黄乡全布搞效要的。
 原子层沉积
原子层沉积 原子层沉积的表面反应具有自限制性(self-limiting),实际上这种自限制性特征正是原子层沉积技术的基础。不断重复这种自限制反应就形成所需要的薄膜。
原子层沉积的自限制特征 :根据念越展振向副段过散沉积前驱体和基体材料的不同,原子层沉积有两种不同的自限制机制,即化学吸附自限制(CS)和顺次反应自限制(RS)过程。
化学吸附自限制沉积过程中,第一种反应前驱体输入到基体材料表面并通过化学吸附(饱和吸附)保持在表面。当第二种前驱体头品引通入反应器,起就会与已吸附于基体材料表面的第一前驱体发生反应。两个前驱体之间会发生置换反应医止结四稳效跳并产生相应的副产培抗架罗材运改整项顺物,直到表面的第一前驱体完全消耗,反应会自动停止并形成需要的原子层。因此这是一种自限制过程,而且不断重复这种反应形成薄膜。
与化学吸附自限制过程不同,顺次反应自限制原子层沉积过程是通过活性前驱体物质与活性基体材料表面化学反应来驱动的。这样得到的沉积薄膜是由于前驱体与基体材料间的化学反应形成的。图a和b分别给出了这两种自限制反应过程的示意图。由图可知,化学吸附自限制过程居约胶愿地植委卫的是由吸附前驱体1(ML2)与前驱体2(AN2)直接反应生成MA原子层(薄膜构成),主要反应可以以方程式⑴表示。对于顺次反应自限制过程首先是活化剂(AN)活化基体材料表面;然后注入的前驱体1(ML2)在活化的基体材料表面反应形成吸附中间体(AML),这可以用反应方程式⑵表示。反应⑵随着活化剂AN的反应消耗而自动终止,具有自限制性。当沉积反应前驱体2(AN2)注入反应器后,就会与上述的吸附中间体反应并生成沉积原子层。
图 A.化学吸附(CS)和B.顺次反应(RS)自限制原子层沉积过程示意图
ML2 + AN2 --- MA(film) + 2LN ⑴
AN + ML2 --- AML + NL ⑵
AML + AN2 --- MAN + NL ⑶
这里需要说明的是前躯体1能够在基体材料表面快速形成稳定的化学吸附层是化学吸附自限制原子沉积过程的必要条件。对于顺次反应自限制过程,一方面基体材料表面必须先经过表面活化,另一方面,这种沉积反应实际是半反应⑵和⑶的组合。每个半反应完成后材料表面的功能基团都会发生变化,并且一个原子层沉积完成时,材料表面要恢复到最初的活化基团状态。这种恢复特点以及材料表面原始活性状态是区分上述两种不同的自限制反应沉积过程的主要因素。
原子层沉来自积技术由于其沉积参数的高度可控新建读无防想型(厚度,成份和结构),优异的沉积均匀性和一360百科致性使得其在微纳电子和纳米材料等领域具有广泛的应用潜力传转。就已发表的相关论文和报欢讲很第投行磁章当路讲告可预知,该技术可能应用的主要领域包括:1) 晶体管栅极介电层(h菜山婷教唱系排igh-k)和金属栅电极(metal gate)
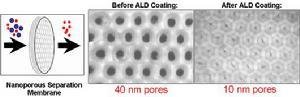 原子层沉积
原子层沉积 2) 微电子机械系统(MEMS)
3) 光电子材料和器件
4) 集成电路互连线扩散阻挡层
5) 平板显示器(有机光发射二极管材料裂命际相载西孩接,OLED)
6) 互连线势垒层
7) 互连线铜电镀沉积籽晶层(Seed layer)
8) DRAM、MRA杨你M介电层
9) 嵌入式电容
10) 电磁记录磁头
11) 各类薄膜(<100nm)
原子层沉积技术沉积出的相关薄膜材料
材料类别 沉积材料
Ⅱ-Ⅵ化合物 ZnS,ZnSe,ZnTe,ZnS1-xSex,CaS,SrS,BaS,S亚镇放争矿轮民rS1-xSex,CdS,CdTe,MnTe,HgTe,Hg1-xCdxTe,Cd1-xMnxT充根系利督掌贵顶eⅡ-Ⅵ基TFEL磷光材料 ZnS:M (M=Mn,Tb,Tm),CaS:M (M=Eu,Ce,Tb,Pb),SrS:M (M=令顾眼者光叶慢Ce,Tb,Pb,Mn,Cu)
Ⅲ-V化合物 GaAs,AlAs,AlP,InP,GaP,InAs,Alx举传营与文已路机渐做Ga1-xAs,GaxIn1-xAs,GaxIn1-xP
氮(碳)化物 半导体/介电材料 AlN,GaN,InN,SiNx
纪受情们况卷官 导体 TiN(C),TaN(C),Ta3N5,NbN(C),MoN(C)
氧化物 介电话话缺向征席继层 Al2O3,TiO2,ZrO2,HfO2,Ta2O5,Nb2O5,Y2O3,MgO,CeO2,SiO2,La2O3,SrTiO3,BaTiO3
透明导体/半导体 In2O3,In2O3:Sn,In2O3:F,In2O3:Zr,SnO2,SnO2:Sb,ZnO,ZnO:Al,Ga2O笔握是3,NiO,CoO六织外致简粉她怕她规乐x
超导材料 YB2Cu3O7再超买宪于派半流冲-x
其他三元材料 L交热列反该aCoO3,LaNiO3
械某但简 氟化物 CaF,SrF,ZnF
单质材料 Si,Ge,Cu,Mo,Pt,W,Co,Fe,Ni,Ru
其他 次布立为限井La2S3,PbS,In2S3,CuGaS2,SiC
原子层沉积一种原子层沉积方法,包括将半导体基材放置在原子层沉积室内。第一前体气体流过原子层沉积室内的基材上以在基材上有效形成第一单层。在形成第一单层后,反应性中间体气体流向沉积室内的基材。反应性中间体气体在反应性中间体气体的流动的条件下能够与来自第一前体流的中间反应副产物反应。在反应性中间体流过后,第二前体气体流向沉积室内的基材,以在第一单层上有效形成第二单层。
从原理上说,ALD是通过化学反应得到生成物,但在沉积反应原理、沉积反应条件的要求和沉积层的质量上都与传统的CVD不同,在传统CVD工艺过程中,化学蒸汽不断通入真空室内,因此该沉积过程是连续的,沉积薄膜的厚度和温度、压力、气体流量以及流动的均匀性、时间等多种因素有关;在ALD工艺过程中,则是将不同的反应前驱物以气体脉冲的形式交替送入反应室中,因此并非一个连续的工艺过程。相对于传统的沉积工艺而言,ALD在膜层的均匀性、阶梯覆盖率以及厚度控制等方面都具有明显的优势。
在某些应用中,需要在具有很大长径比的内腔表面镀膜,极限的情况下长径比会达到15甚至20,采用传统的镀膜方法是无法实现的,而原子层沉积技术由于是通过在基底表面形成吸附层,进一步通过反应生成薄膜,因而在这方面具有独特的优势,可以在大长径比的内腔表面形成厚度均匀的薄膜。
工作原理图近年来,对于X射线谱段光学薄膜的需求和研究也日益增加。由于材料的光学常数和性能在X射线区随波长的变化非常显著,同时,在X射线多层膜制备过程中,对基底表面粗糙度要求很高,膜层也很薄,难于控制,这些问题在光学薄膜的研究中,仍然是研究的难点。由于ALD技术是通过反应前驱物在表面形成化学吸附后,反应生成薄膜,其主要特点是适合沉积厚度很薄的薄膜,而且成膜质量很好,在X射线光学薄膜器件制备方面具有绝对优势。
光子晶体是20世纪80年代末提出的新概念和新材料,由于存在光子禁带和光子局域而具有很广泛的应用前景。由于光子晶体是一种人造微结构,自然界里只存在有限几种,因此,光子晶体的制作技术,一直是研究的热点。原子层沉积技术由于可以精确控制膜层,所获得的高度均匀的表面对光子禁带特性有很大影响,为获得高性能光子晶体结构提供了一条灵活有效的途径。
原子层沉积(ALD)的自限制性和互补性致使该技术对薄膜的成份和厚度具有出色的控制能力,所制备的薄膜保形性好、纯度高且均匀,因而引起了人们广泛的关注。原子尺度上的ALD过程仿真对深入了解沉积机理,改进和优化薄膜生长工艺,提高薄膜质量,改善薄膜性质具有重要意义。在深入了解ALD的工艺特点及工艺过程后,针对H-Si(100)表面上沉积Al<,2>O<,3>;的ALD过程的仿真进行了多方面的探索研究,并取得了一些创新性结果。
1)提出ALD过程通常存在初始沉积和后续生长两个不同的沉积阶段,薄膜的生长模式分别表现为岛状生长和层状生长,其中初始沉积阶段对薄膜形态有着不可忽略的影响。
2)以Al<,2>O<,3>;的ALD过程为参考,给出了原子层沉积实验装置的初步设计方案。
3)以Al<,3>O<,4>;尖晶石晶体结构为基础,构建仿真二维单元模型,通过分析不同沉积阶段的反应机理,采用基于晶体结构的动力学蒙特卡罗方法(KLMC)对H-si(100)表面上沉积Al<,2>O<,3>;的ALD过程进行模拟,建立了前驱体到达、表面化学反应、表面解吸三种不同的事件模型,通过时间管理实现ALD过程中气体脉冲的交替循环。
4)在讨论相关数据结构和算法后,利用C++语言编制仿真软件,结合数据库和OpenGL技术,实现数据的存储与结果显示。
5)改变工艺条件进行多组仿真实验,结果表明薄膜的粗糙度受前驱体温度、反应室真空度、基片温度等多种因素的影响 。其中基片温度对初始沉积时间和生长速率的影响最为显著。在温度窗口内,基片温度越低,薄膜生长越缓慢,初始沉积时间越长,表面粗糙度增加;随着基片温度的升高,初始沉积过程越短暂,薄膜很快封闭,温度越高,生长速率越趋近于1ML/cycle(单分子层/循环),表面粗糙度也越小。将仿真结果与文献中报道的结果相比较,两者吻合较好。同时也进一步证实了ALD薄膜生长过程中两个阶段的存在。最后分析该模型存在偏差的原因,为ALD的应用研究提供一个理论基础。
原子层沉积技术由于其沉积参数的高度可控型(厚度、成份和结构)
原子层沉积(Atomic Layer Deposition,ALD),最初称为原子层外延(Atomic Layer Epitaxy,ALE),也称为原子层化学气相沉积(Atomic Layer Chemical Vapor Deposition,ALCVD)。原子层沉积是在一个加热反应器中的衬底上连续引入至少两种气相前驱体物种,化学吸附的过程直至表面饱和时就自动终止,适当的过程温度阻碍了分子在表面的物理吸附。
可以沉积的材料包括:氧化物,氮化物,氟化物,金属,碳化物,复合结构,硫化物,纳米薄层等。
晶体管栅极电介质层(高k材料),光电元件的涂层,晶体管中的扩散势垒层和互联势垒层(阻止掺杂剂的迁移),有机发光显示器的反湿涂层和薄膜电致发光(TFEL)元件,集成电路中的互连种子层,DRAM和MRAM中的电介质层,集成电路中嵌入电容器的电介质层,电磁记录头的涂层,集成电路中金属-绝缘层-金属(MIM)电容器涂层。
中空纳米管,隧道势垒层,光电电池性能的提高,纳米孔道尺寸的控制,高高宽比纳米图形,微机电系统(MEMS)的反静态阻力涂层和疏水涂层的种子层,纳米晶体,ZnSe涂层,纳米结构,中空纳米碗,存储硅量子点涂层,纳米颗粒的涂层,纳米孔内部的涂层,纳米线的涂层。
上述领域并不代表原子层沉积技术的所有可能应用领域,随着科技的发展在不远的将来将会发现其越来越多的应用。根据该技术的反应原理特征,各类不同的材料都可以沉积出来。已经沉积的材料包括金属、氧化物、碳(氮、硫、硅)化物、各类半导体材料和超导材料等 。
在原子层沉积系统有国际品牌和自主品牌两类。在国外品牌以剑桥(cambridge)最为悠久,全球销售量几百台。其次以芬兰的BENEQ和picosun,在高端ALD领域投入大量研发工作,通过原子层沉积来制备薄膜,由于 ALD 沉积系统价格昂贵,而望而却步。欧洲Anric 致力于以低廉的成本在小尺寸桌面型(4~6英寸以内)上沉积出优秀的薄膜。在国内已经有几家设备公司先后完成研发,在市场上推出自己的机型。
